芯片技术的挑战者“大阅兵”
10-02 09:13
8,410
本文来自格隆汇专栏:半导体行业观察;作者:杜芹DQ
行业也并没有放弃摩尔定律,只是每一次的进步都异常艰难
自1971年英特尔推出第一款4004芯片以来,集成电路中的晶体管数量以惊人的速度增长。现在,半导体行业不得不承认,“微芯片上的晶体管数量大约每18个月增加一倍”通过调整晶体管大小来跟上摩尔曲线的心血管是不可持续的,维持这种进步速度的成本是天文数字——晶体管密度每增加一倍,就需要资本投入同时增加一倍,而且物理问题也层出不穷。
但人工智能、5G和数据中心等应用对芯片的需求仍在继续,半导体仍要继续发展。行业也并没有放弃摩尔定律,只是每一次的进步都异常艰难。在芯片继续演进的前路,各技术齐上阵,展示着各自的实力和潜力,但也各有各自的限制和不足。
封装技术
首先是封装技术。封装技术是一项无法进行的功率计算。随着大功率需求的提升,以及单芯片向更先进的制程推进引脚的增加,芯片性能的进步更多地依赖于包括重要封装、曾经,封装方案被认为是承载和连接半导体所必需的组件。现在,先进封装被认为是推进半导体技术先进性前沿的机会,封装的一大优势就是它可以相互增加连的密度,从而提高信号速度和整体处理能力。这促使企业大力投资先进封装研究和资本。也因此,《先进封装,轰动大爆发》,据Yole预测,封装市场在2022年的价值22亿美元,预计到2028年将超过160亿美元,2022-2028年的复合年将为40%。

先进封装玩家一览
(图源:Yole)
顶尖的先进封装技术都掌握价值在晶圆代工封装上,由于先进封装提供了比传统封装封装更高的机会,因此主要参与者和快速追随者正在开发各种形式的封装技术其商业化,以此赢得优质客户。台积电、英特尔和三星是推动先进封装创新的主要参与者。台积电利用CoWoS、InFO和3D SoIC解决方案提供了3DFabric技术平台。英特尔也积极布局2.5D/3D封装技术,如Foveros、 EMIB和Co-EMIB产品,以及继承的Foveros Direct & Omni。三星有I- CubeS 、H-Cube,以及继承的R-Cube和X-Cube等2.5D和3D封装技术。因此它们之间,都围绕着先进性封装的竞争也愈加疲劳,《代工党“拼”先进封装》。
从硅技术上来看,他们主要采用了采用Through-Silicon Via,TSV)、模具通孔(Through-Mold Via,TMV)、微凸块和混合键合等技术来缩小互连长度。3D封装发展的初期主要是通过裸片上的一个小铜凸块来提供芯片之间的垂直连通。凸块的尺寸范围只能从40 µm到最终缩小到20 µm或10 µm尺寸,混合键合技术是实现10μm及以下间距另一个有潜力的连接技术,它利用小型的铜对铜连接来连接封装中的裸片,能够为3D封装提供卓越的互联密度。
除此之外,晶圆代工厂商甚至开始向封装材料上进,英特尔于9月18日,对外披露了其半导体玻璃关键技术的开发进展,《开启了下一代封装革命》。英特尔认为,有机材料不仅消耗更多的电流,且具有膨胀和翘曲等限制,到2030年前,半导体产业很可能会达到使用有机材料在硅封装上延展电晶体数量的极限,玻璃基板将是下一代半导体确实可行且堆积器的进展。 搭建主机基板,玻璃基板具备卓越的机械、物理和光学特性,在单一封装中可连接更多电晶体,提高延展性并能构成更大的系统级封装(SiP)芯片架构师将能够在一个封装上提供更小的封装、更小的芯片,同时获得更高的弹性、更高的总体成本和功耗,实现同样的效果并增加密度。
互联技术
“互连”也是芯片技术挑战的重要参与者。曾经,晶体管的速度是抵消芯片性能的限制因素,但随着当今动极数百万晶体管芯片的出现,更多的晶体管使得线路的电阻也承受另外,在间隔非常近的互连线路之间可能会发生电容耦合。这两者都影响了信号的传输。其次,芯片的计算能力(FLOP)在每一代芯片/封装中增长速度均快输入和输出数据的速度。如今,互连已经成为一大限制。
在芯片互联技术上,目前铜互连仍然是普遍普遍的做法。1997年,IBM率先从铝互连转向铜互连,自那时起,铜互连一直是用于制造逻辑放大器(BEOL)应用但随着芯片工艺迈入更先进的工艺,在10nm尺寸越来越小,铜的电阻率将会增加,从而开始影响电子电路的性能。
于是,行业也随之发起对铜以外的新材料的探寻。研究显示,钴(Co)、钌(Ru)、钌(Rh)、铱(Ir)和钼(Mo)等材料在尺寸更小下具有更好的抵抗表现。除此之外,像imec这样的研究机构在大约五年前就开始为未来互联应用寻找替代二元和三元合金金属的研究。具体可查看《替代铜互连,新的里程碑》 》一文。但是想要新材料替代铜互连,并非易事。《铜互连,还是无法替代?》
互联不仅包括硬件层面的物理互联,还包括更高层次的接口和协议技术(如不同设备或系统之间的通信接口和标准)。如PCIe、以太网、NVMe、Linux、TCP/IP、RDMA这些接口技术都在互联方面发挥着重要的作用。近些年来,在数据中心存储和数据处理的爆炸性需求,以及传统的DDR内存接口的带宽和容量扩展有限的情况下,一些新型的接口互联技术被开发出来。
其中一个互联技术的挑战者是,英特尔于2019年3月在InterconnectDay 2019上推出开放性互联协议Compute Express Link (CXL),已成为业界和学术界认为最有前景的接口技术之一,因为它不仅可用于内存容量和带宽的扩展,还能够实现内存的拆分。这几年其标准发展迅速,知名芯片厂商已在其产品布局中宣布支持CXL。在《揭开CXL内存的神秘面纱》一文中对CXL进行了精彩的描述。
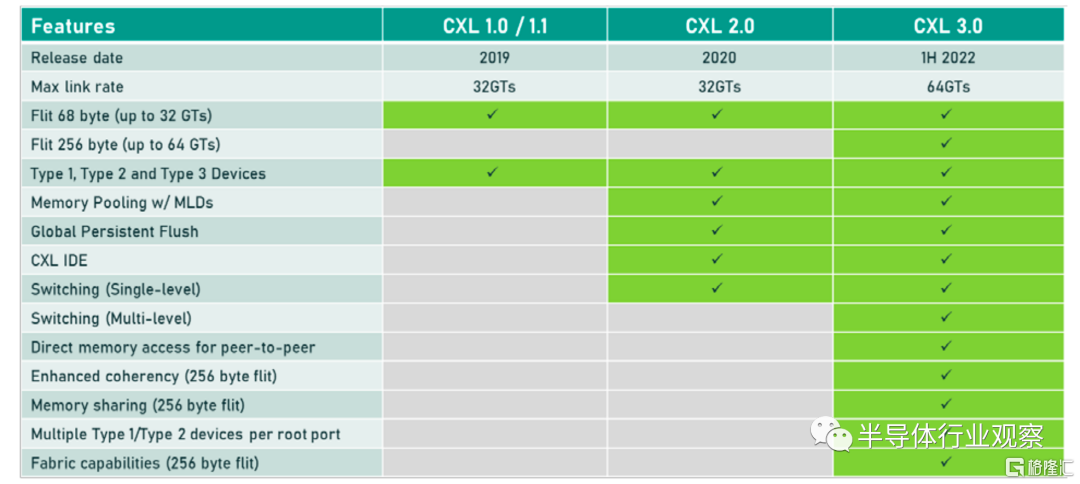
不同版本CXL对比
(来源:CXL3.0PDF)
另外一个就是现在大火的Chiplet,在后摩尔时代,Chiplet这样的先进封装技术在推动芯片性能继续提升上关键。其接口技术标准UCIe也于2022年推出,发展至今,UCIe联盟已经发布了两个一个版本,分别是UCIe 1.0和1.1。《Chiplet,怎么连?》一文中指出,Chiplet当前正处于一个发展阶段,能否成为一种新的IP产品和商业模式,甚至拯救摩尔定律的救星,关键就在于目前尚未达成统一的Chiplet互联标准,建立一个开放和标准化的Chiplet生态。
另外,还有一些公司推出强调的互联技术,例如英伟达的NVlink技术,它在今年早些时候推出了一款独立的128端口NVLink交换机系统,配备800G OSFP接口,可直接连接多达256个Hopper H100 GPU。
硅光芯片也是一项有潜力的技术,随着近年来光子芯片的厂商越来越多,例如Intel、Ayar Labs、博通、思科、国内还有曦智科技等一家头部企业。提升光电传输的速度,有效解决目前元件使用铜导线所面临的信号耗损机热量随之而来的问题,,被寄予厚望的《光芯片照明计算机黄金时代》。但硅光子仍面临着高制造成本、光源集成、材料匹配、热效应等瓶颈。
据650集团研究机构发布的《数据中心互连半导体预测与研究报告》中指出,数据中心计算现在和未来几年的发展代表着架构的转型。互连芯片的创新和技术转型将大幅提高每个单位功率和每单位成本的系统I/O带宽,从而实现人工智能和加速计算集群的尺寸和代际的扩展。数据中心互连半导体市场(即支持跨计算、存储和网络系统的高性能数据通信)芯片技术的价值)预计将在2022年至2027年内翻一番,达到近250亿美元,年复合达到这几个数字。
新的供电方式
随着我们不断缩小晶体管和IC的尺寸,供电成为片上的一个重大挑战。根据应用材料的介绍,目前所有芯片都需要从芯片的前端提供电力,这大约需要通过超过12层的布线,引脚晶体管。方法有两个主要限制:芯片上宝贵的空间必须分配给电源线,而且当电源突破到达阈值时会损坏电源。背面供电(BPDN)或有助于挽救摩尔定律。
背面供电网络的基本思想是去掉所有从硅表面上方发送电力(而不是数据信号)的互连,把它们放置在硅表面下方。理论上这可以减少功率损耗,因为功率传输互连可以更大且电阻更小。它还为信号承载互连释放了晶体管层上方的空间,可能导致更简洁的设计。
目前包括imec、英特尔(PowerVia)、台积电、三星等都在研发这项技术,一些芯片制造商已公开宣布在2nm及以上技术节点的逻辑IC中引入背面供电网络。 《背面供电技术,越来越多》热!》背面但是供电技术需要的器件架构、新材料开发、材料的单片和独立集成、更大的晶圆尺寸和单晶圆处理,才能满足此前的应用要求。
新型材料
新型材料也是焦点之一。过去几十年,硅材料是芯片行业的统治者。根据赫尔辛基大学设备研究与工程实验室教授 Deep Jariwala 的说法,“我们已经达到了这样一个进步,即使你可以继续缩小硅,它已经到了不再节能的地步。”因此,行业研究学者对新型材料的探索孜孜不倦。潜在的硅替代者主要有二维材料如石墨烯、各种氧化物、金刚石、有机材料等。被视为未来芯片技术的希望。
包括台积电和英特尔的商业企业,以及麻省理工、赫尔大学等科研机构已经对二维材料进行了不同程度的研究,其中,大量的研究报告表明,基于二维过渡金属二硫族化合物如MoS2和WSe2的晶体管是接替硅的重要候选者。《工会开始,七篇论文,二维材料的新进展》。随着行业对二维材料研究的增加,其已逐步走向制造。
碳纳米管(CNT)是另一种被寄予厚望的新材料,被认为是下一代高性能、超大规模和晶体管晶体管以及光电器件的候选者。碳和硅一样,不是什么新材料,来自碳纳米管管子可能被安装在高性能数字电子设备以及射频和传感应用的平台上。而且它可以通过化学气相沉积(CVD)方法,能够在CMOS工厂成功制造。《下一代的晶体管替代,不是硅!》一篇文章对碳纳米管进行了详细的介绍。
二氧化铪这样的新型材料为存储其实新型存储提供了更多的可能性。通过研究发现,二氧化铪具有铁电的特性,这样的好处是它在不供电的情况下也可以长久存储数据,意味着其价值可以再非易失性内存领域发挥。总而言之,《铪基氧化物材料有望成为未来芯片的选择》。
结语
Imec 预测,晶体管的形式将在未来十年发生变化,连接它们的金属物种会发生变化。最终,晶体管可能是由二维半导体而不是硅片制成的器件,电力传输和其他基础设施可以分层放置在晶体管底部。为了保持摩尔定律的正常运行,所有可能的杠杆都会被拉动,除了前面提到的这些,还有下一代光刻技术、工具等各领域的支持。最终,我们可以将摩尔曲线延伸到什么程度可能完全是一个经济学问题。

Imec的CMOS 2.0路线图,很有趣